QR Code

Tungkol sa Amin
Mga produkto
Makipag-ugnayan sa amin

Telepono

Fax
+86-579-87223657

E-mail

Address
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Ang kemikal na mekanikal na buli (CMP) ay nag -aalis ng labis na materyal at mga depekto sa ibabaw sa pamamagitan ng pinagsamang pagkilos ng mga reaksyon ng kemikal at mekanikal na pag -abrasion. Ito ay isang pangunahing proseso para sa pagkamit ng pandaigdigang pagpaplano ng ibabaw ng wafer at kailangang-kailangan para sa mga magkakaugnay na tanso ng tanso at mga istrukturang mababang-K dielectric. Sa praktikal na pagmamanupaktura, ang CMP ay hindi isang perpektong pantay na proseso ng pag -alis; Nagbibigay ito ng mga tipikal na depekto na nakasalalay sa pattern, na kung saan ang dishing at pagguho ay ang pinakatanyag. Ang mga depekto na ito ay direktang nakakaapekto sa geometry ng mga magkakaugnay na layer at ang kanilang mga de -koryenteng katangian.
Ang dishing ay tumutukoy sa labis na pag-alis ng medyo malambot na conductive na materyales (tulad ng tanso) sa panahon ng CMP, na humahantong sa isang profile na may hugis ng ulam sa loob ng isang solong linya ng metal o isang malaking lugar ng metal. Sa cross-section, ang sentro ng linya ng metal ay mas mababa kaysa sa dalawang gilid nito at ang nakapalibot na dielectric na ibabaw. Ang kababalaghan na ito ay madalas na sinusunod sa malawak na linya, pad, o mga block-type na mga rehiyon ng metal. Ang mekanismo ng pagbuo nito ay pangunahing nauugnay sa mga pagkakaiba -iba sa materyal na katigasan at ang pagpapapangit ng buli pad sa malawak na mga tampok ng metal: ang mga malambot na metal ay mas sensitibo sa mga sangkap ng kemikal at mga abrasives sa slurry, at ang lokal na presyon ng contact ng pad ay nagdaragdag sa malawak na mga tampok, na nagiging sanhi ng pag -alis ng rate sa gitna ng metal na lumampas sa mga gilid. Bilang isang resulta, ang lalim ng dishing ay karaniwang tumataas na may lapad ng linya at sobrang oras na oras.
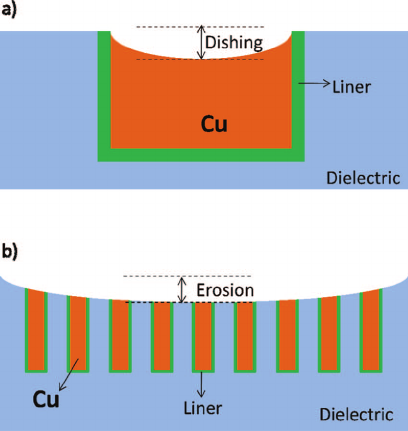
Ang pagguho ay nailalarawan sa pamamagitan ng pangkalahatang taas ng ibabaw sa mataas na mga rehiyon ng pattern-density (tulad ng mga siksik na linya ng metal na linya o mga lugar na may siksik na dummy punan) na mas mababa kaysa sa nakapalibot na mga kalat na rehiyon pagkatapos ng CMP. Sa esensya, ito ay isang pattern-density-driven, antas ng rehiyon na over-roval ng materyal. Sa mga siksik na rehiyon, ang metal at dielectric na magkasama ay nagbibigay ng isang mas malaking epektibong lugar ng pakikipag -ugnay, at ang mekanikal na alitan at kemikal na pagkilos ng pad at slurry ay mas malakas. Dahil dito, ang average na mga rate ng pag-alis ng parehong metal at dielectric ay mas mataas kaysa sa mga rehiyon na may mababang density. Tulad ng pagpapatuloy ng buli at labis na pagparurog, ang metal-dielectric stack sa mga siksik na lugar ay nagiging mas payat sa kabuuan, na bumubuo ng isang masusukat na hakbang na taas, at ang antas ng pagguho ay nagdaragdag sa lokal na pattern ng pattern at proseso ng pag-load.
Mula sa pananaw ng aparato at proseso ng pagganap, ang dishing at pagguho ay may maraming masamang epekto sa mga produktong semiconductor. Binabawasan ng dishing ang epektibong cross-sectional area ng metal, na humahantong sa mas mataas na magkakaugnay na paglaban at pagbagsak ng IR, na kung saan ay nagiging sanhi ng pagkaantala ng signal at nabawasan ang tiyempo sa mga kritikal na landas. Ang mga pagkakaiba -iba sa dielectric na kapal na sanhi ng pagguho ay nagbabago ng kapasidad ng parasitiko sa pagitan ng mga linya ng metal at ang pamamahagi ng pagkaantala ng RC, na pinapabagsak ang pagkakapareho ng mga de -koryenteng katangian sa buong chip. Bilang karagdagan, ang lokal na dielectric thinning at electric field na konsentrasyon ay nakakaapekto sa pag-uugali ng breakdown at pangmatagalang pagiging maaasahan ng mga dielectrics ng inter-metal. Sa antas ng pagsasama, ang labis na topograpiya ng ibabaw ay nagdaragdag ng kahirapan ng pagtuon ng lithography at pagkakahanay, pinapabagal ang pagkakapareho ng kasunod na pag -aalis ng pelikula at pag -etching, at maaaring mag -udyok sa mga depekto tulad ng nalalabi na metal. Ang mga isyung ito sa huli ay nagpapakita bilang pagbabagu -bago ng ani at isang window ng pag -urong ng proseso. Samakatuwid, sa praktikal na engineering, kinakailangan upang makontrol ang dishing at pagguho sa loob ng tinukoy na mga limitasyon sa pamamagitan ng pagkakapantay -pantay ng density ng layout, pag -optimize ngbuli sLURRYpagpili, at pinong pag-tune ng mga parameter ng proseso ng CMP, upang matiyak ang planarity ng mga istrukturang magkakaugnay, matatag na pagganap ng elektrikal, at matatag na mataas na dami ng pagmamanupaktura.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Lahat ng Karapatan ay Nakalaan.
Links | Sitemap | RSS | XML | Patakaran sa Privacy |
