QR Code

Tungkol sa Amin
Mga produkto
Makipag-ugnayan sa amin

Telepono

Fax
+86-579-87223657

E-mail

Address
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Pag-ukitAng teknolohiya ay isa sa mga pangunahing hakbang sa proseso ng pagmamanupaktura ng semiconductor, na ginagamit upang alisin ang mga tukoy na materyales mula sa wafer upang makabuo ng isang pattern ng circuit. Gayunpaman, sa panahon ng proseso ng dry etching, ang mga inhinyero ay madalas na nakatagpo ng mga problema tulad ng pag-load ng epekto, epekto ng micro-groove at epekto ng singilin, na direktang nakakaapekto sa kalidad at pagganap ng panghuling produkto.
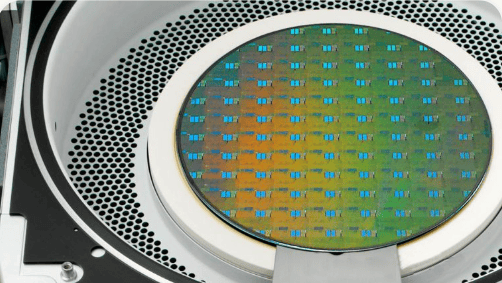
Ang pag -load ng epekto ay tumutukoy sa kababalaghan na kapag ang lugar ng etching ay tumataas o ang lalim ng etching ay nagdaragdag sa panahon ng dry etching, bumababa ang etching rate o ang etching ay hindi pantay dahil sa hindi sapat na supply ng reaktibo na plasma. Ang epekto na ito ay karaniwang nauugnay sa mga katangian ng sistema ng etching, tulad ng density ng plasma at pagkakapareho, degree ng vacuum, atbp, at malawak na naroroon sa iba't ibang reaktibo na ion etching.
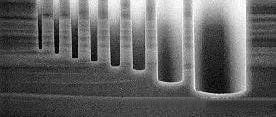
AtPagbutihin ang density at pagkakapareho ng plasma: Sa pamamagitan ng pag-optimize sa disenyo ng pinagmumulan ng plasma, gaya ng paggamit ng mas mahusay na RF power o magnetron sputtering technology, maaaring makabuo ng mas mataas na density at mas pantay na namamahagi ng plasma.
AtAyusin ang komposisyon ng reaktibong gas: Ang pagdaragdag ng isang naaangkop na halaga ng pantulong na gas sa reaktibo na gas ay maaaring mapabuti ang pagkakapareho ng plasma at itaguyod ang epektibong paglabas ng mga etching byproducts.
AtI -optimize ang sistema ng vacuum: Ang pagpapahusay sa bilis ng pumping at kahusayan ng vacuum pump ay maaaring makatulong na bawasan ang oras ng paninirahan ng mga byproduct ng pag-ukit sa silid, sa gayon ay binabawasan ang epekto ng pagkarga.
AtMagdisenyo ng isang makatwirang layout ng photolithography: Kapag nagdidisenyo ng layout ng photolithography, dapat isaalang-alang ang density ng pattern upang maiwasan ang sobrang siksik na pag-aayos sa mga lokal na lugar upang mabawasan ang epekto ng epekto ng pagkarga.
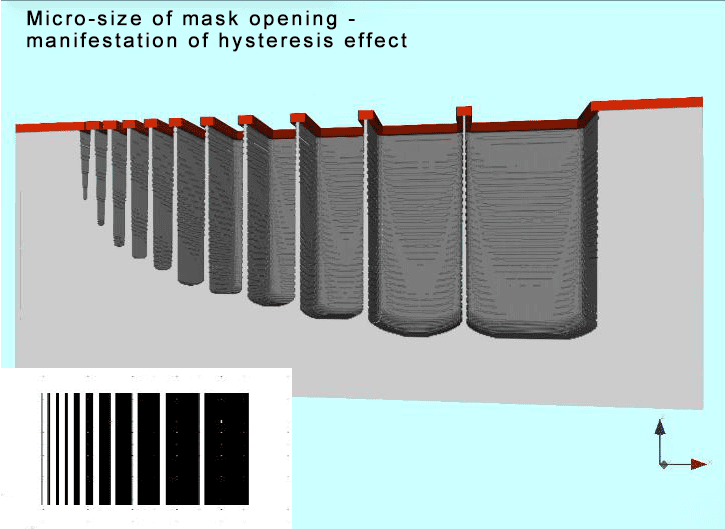
Ang epekto ng micro-trenching ay tumutukoy sa hindi pangkaraniwang bagay na sa panahon ng proseso ng pag-ukit, dahil sa mga particle na may mataas na enerhiya na tumama sa ibabaw ng etching sa isang hilig na anggulo, ang rate ng pag-ukit malapit sa gilid ng dingding ay mas mataas kaysa sa gitnang lugar, na nagreresulta sa hindi -vertical chamfers sa gilid ng dingding. Ang hindi pangkaraniwang bagay na ito ay malapit na nauugnay sa anggulo ng mga particle ng insidente at ang slope ng side wall.
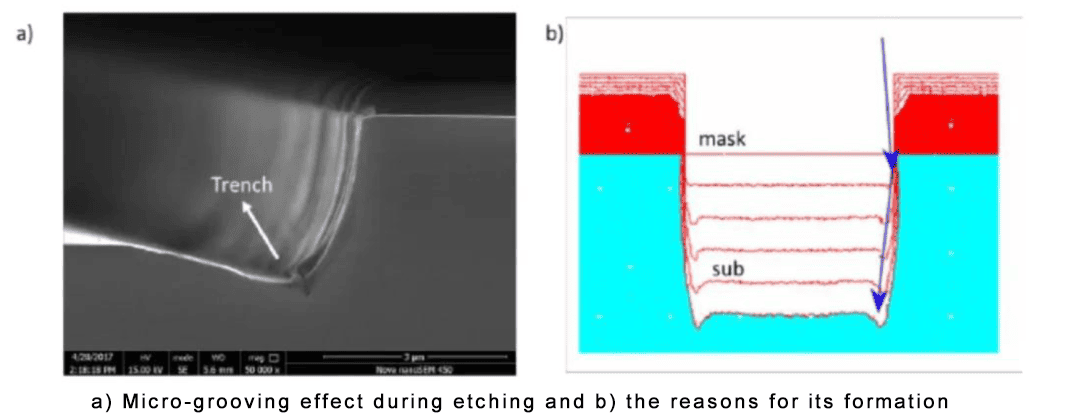
AtPalakihin ang RF power: Ang wastong pagpapataas ng RF power ay maaaring magpapataas ng enerhiya ng mga particle ng insidente, na nagbibigay-daan sa kanila na bombahin ang target na ibabaw nang mas patayo, at sa gayon ay binabawasan ang etching rate difference ng side wall.
AtPiliin ang tamang etching mask na materyal: Ang ilang mga materyales ay maaaring mas mahusay na pigilan ang epekto ng singilin at mabawasan ang epekto ng micro-trenching na pinalubha ng akumulasyon ng negatibong singil sa mask.
AtI-optimize ang mga kondisyon ng pag-ukit: Sa pamamagitan ng makinis na pag -aayos ng mga parameter tulad ng temperatura at presyon sa panahon ng proseso ng etching, ang pagpili at pagkakapareho ng etching ay maaaring mabisang kontrolado.
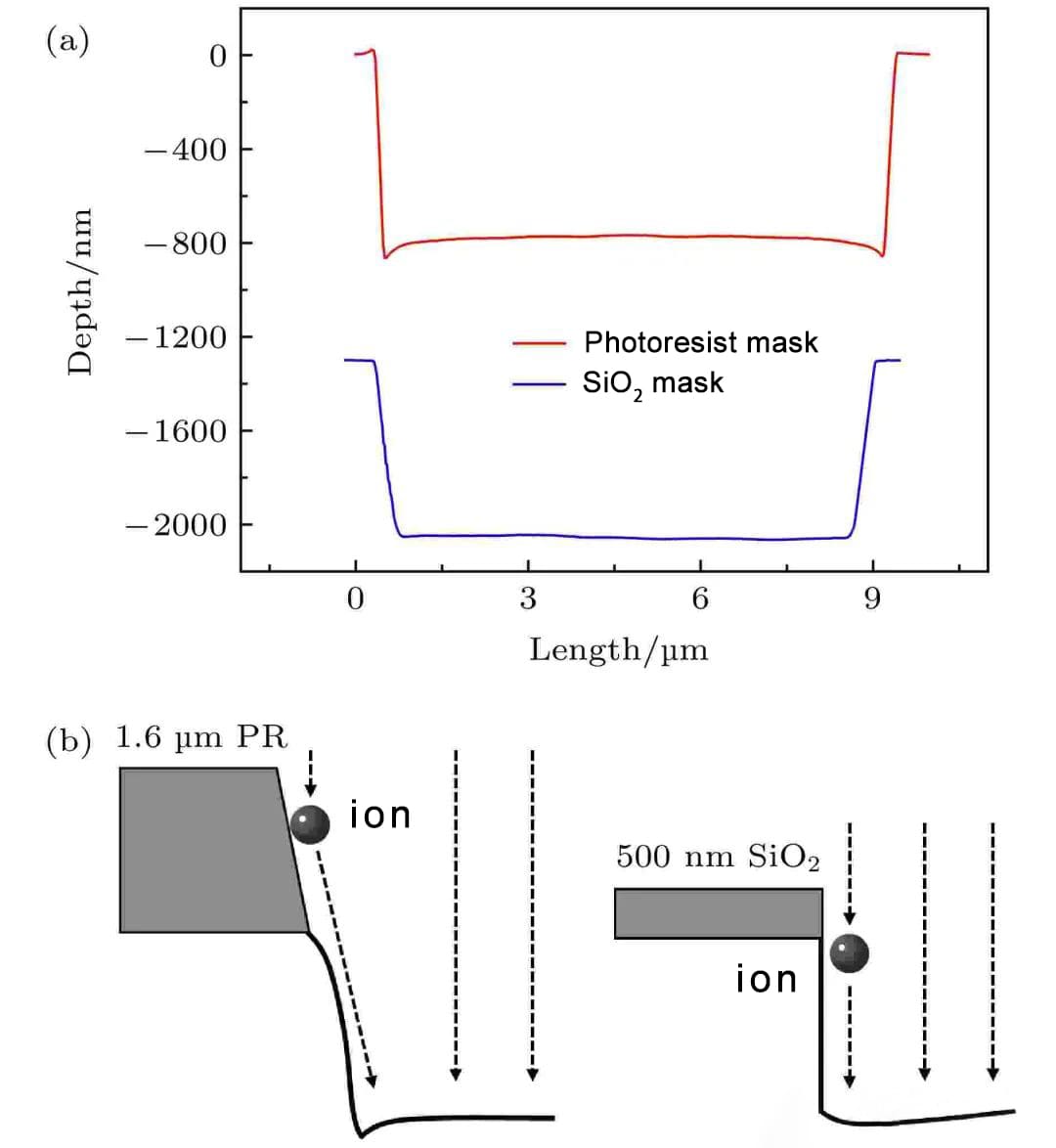
Ang epekto ng singilin ay sanhi ng mga insulating na katangian ng etching mask. Kapag ang mga electron sa plasma ay hindi makatakas nang mabilis, magtitipon sila sa ibabaw ng mask upang makabuo ng isang lokal na larangan ng kuryente, makagambala sa landas ng mga particle ng insidente, at nakakaapekto sa anisotropy ng etching, lalo na kapag nag -etching ng mga pinong istruktura.
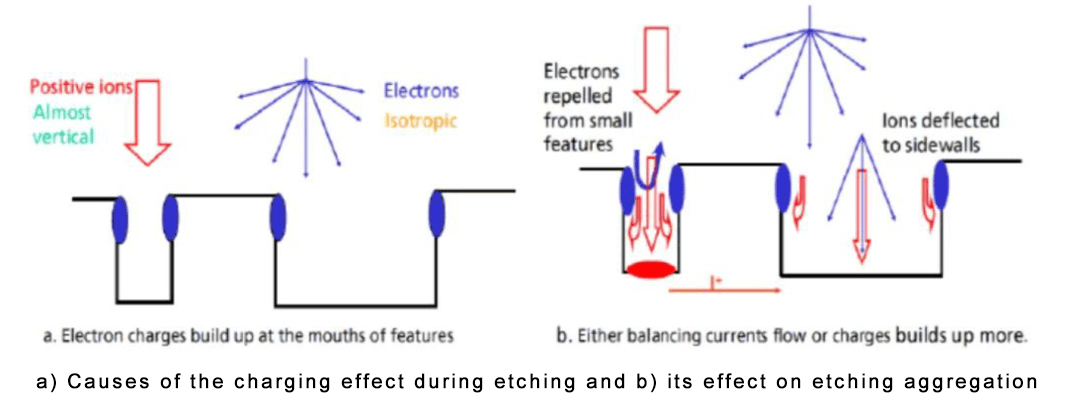
• Pumili ng angkop na materyales sa pag-ukit ng maskara: Ang ilang mga espesyal na ginagamot na materyales o conductive mask layer ay maaaring epektibong mabawasan ang pagsasama -sama ng mga elektron.
AtMagpatupad ng pasulput-sulpot na pag-ukit: Sa pamamagitan ng pana-panahong pagkagambala sa proseso ng pag-ukit at pagbibigay ng mga electron ng sapat na oras upang makatakas, ang epekto ng pagsingil ay maaaring makabuluhang bawasan.
AtAyusin ang kapaligiran ng pag-ukit: Ang pagbabago sa komposisyon ng gas, presyon at iba pang mga kondisyon sa kapaligiran ng pag-ukit ay maaaring makatulong na mapabuti ang katatagan ng plasma at mabawasan ang paglitaw ng epekto ng pagsingil.
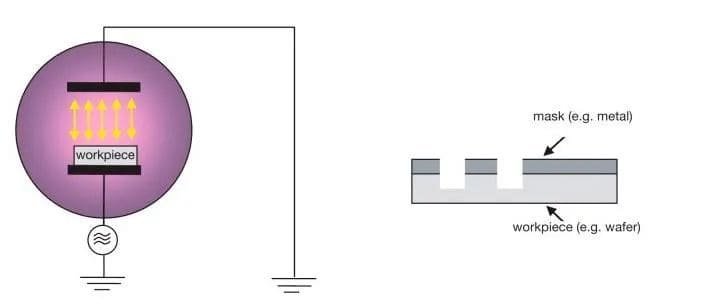



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Lahat ng Karapatan ay Nakalaan.
Links | Sitemap | RSS | XML | Patakaran sa Privacy |
